光刻基本工艺流程之衬底处理
光刻工艺是现代微纳制造中至关重要的技术之一,完整光刻工艺流程包含基底处理、涂胶、前烘、对准曝光、后烘、显影、坚膜、检测等环节,各步骤工艺参数与操作精度直接影响最终的图形质量。本文围绕衬底污染物类型、清洗方式展开介绍。
衬底表面如果存在各种沾污与颗粒,或受湿度影响吸附大量水分子,将会导致光刻胶涂覆不均匀或无法成膜,甚至在后续的显影工艺中发生漂胶现象。这些缺陷对整个光刻工艺具有严重影响。化学清洗以去除沾污和颗粒,加热蒸发水分以及用粘附性促进剂处理,都是光刻胶涂覆前对衬底进行预处理的一部分。
一般说来,新购买的真空包装的衬底(图1),是在严格清洗后进行包装的,因此不需要再次清洗即可直接进行光刻工艺加工。但长时间储存后,衬底表面仍有附着颗粒和有机沾污的可能。在洁净要求较高的光刻工艺中,仍需拆包后进行清洗后再使用。非真空包装的衬底,则必须清洗后才能使用,否则,各类沾污和颗粒将带来严重后果。
湿法清洗是微纳加工领域最常用、最基础的清洗方法。在进行清洗操作之前,先介绍硅片或其他衬底表面的沾污类型,他们大致可以分为三类:有机杂质沾污、颗粒沾污、金属离子沾污。

图1:真空包装衬底材料
有机杂质沾污
在半导体MEMS器件加工中,有机污染物以多种形式存在,包括人体皮脂分泌物、洁净室气载有机分子、设备润滑油脂以及工艺残留物等(图2)。这些污染物会吸附在晶圆表面形成致密的有机薄膜,不仅阻碍清洗溶液与衬底的有效接触,导致污染物清除效率下降,还会干扰后续工艺的均匀性和精度。因此,去除有机物常常作为清洗工序的第一步。

图2:衬底上的有机沾污
颗粒沾污
表面颗粒污染主要来源于工艺残留的聚合物、未完全清除的光刻胶以及蚀刻过程中产生的杂质。这些颗粒(图3)通过范德华力、静电吸附或化学键合作用黏附于衬底表面,其存在会破坏后续工艺的精度,并降低器件的电学性能。对于颗粒污染物,主要采用物理或化学手段颗粒与基底的接触界面,最终将其去除。物理方法通过机械能直接剥离颗粒,机械擦洗或常规超声清洗(20-100kHz)可有效去除粒径≥0.4um的硬质颗粒,高频兆声波能够清除粒径≥0.2um的微细颗粒、聚合物、光刻胶和刻蚀杂质等。化学方法则是通过选择性腐蚀基底或颗粒的界面层,逐步瓦解颗粒的附着支撑结构。

图3:衬底上的颗粒沾污
金属离子沾污
基底表面金属杂质污染根据吸附机制可分为两类。一是物理吸附型污染:金属离子或原子通过范德华力或静电作用非选择性地吸附于基底表面。二是电化学沉积型污染:在湿法工艺的还原性环境中,带正电的金属离子通过获得电子被还原为金属原子,以岛状或层状形貌沉积在基底表面。
金属污染主要源于金属互连工艺的关键环节。该工艺通过光刻和刻蚀技术在绝缘层上形成接触窗口,再借助物理气相沉积或化学气相沉积工艺填充铝、铜等金属形成导电通路。这些步骤都会不可避免地产生金属污染,如光刻图形化过程中的金属掩模侵蚀、等离子体刻蚀导致的腔体材料溅射、铜互连化学机械抛光产生的磨料金属离子等。这些杂质离子会在硅的能带结构中引入杂质能级,这些杂质能级位于禁带中的不同位置,从而形成浅能级和深能级。浅能级主要改变的是衬底的载流子浓度和导电类型,深能级主要影响少数载流子的寿命。金属污染物必须采用化学方法才能彻底清洗。
在硅片表面处理中,除了有机物、颗粒和金属污染外,氧化层的预处理同样至关重要。由于硅的高反应活性,硅片在含氧和水的环境中会自发形成厚度0.5-1.5nm的氧化层。在RCA标准清洗工艺中,SC-1和SC-2中的过氧化氢会导致表面进一步生成1-2nm的化学氧化层。为了确保栅极氧化层的品质,此表面氧化层需要在晶圆清洗后加以去除。
在半导体工艺制程中,硅片清洗的步骤如下:首先,通过强氧化性溶液清除表面有机污染物,其次,采用SC-1溶液去除颗粒污染物,之后利用SC-2溶液清除金属离子,最后,通过稀释的氢氟酸去除氧化层,在硅表面生成钝化层,既消除界面缺陷又抑制氧化再生(图4)。
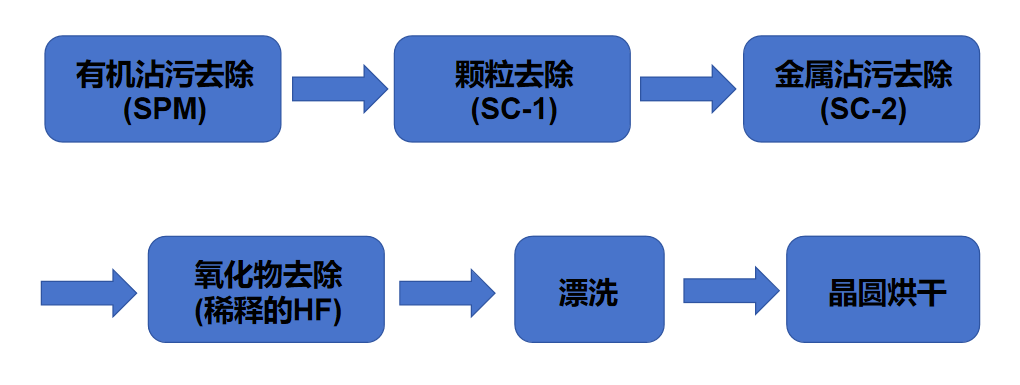
图4:清洗流程图
1. 有机清洗
常用的去除有机污染物的方法包括溶剂清洗和超声波清洗。溶剂清洗是将硅片浸泡在有机溶剂中,通过溶解和扩散的方式去除有机污染物。通常使用“cascadic”清洗,即丙酮I—丙酮II—异丙醇I—异丙醇II。不需要用去离子水进行后续冲洗,因为去离子水清洁邮寄杂质的能力不足,可能会破坏异丙醇的清洁效果。
在溶剂清洗过程中可同时使用超声波清洗。超声波清洗技术是利用高频声波在液体中引发空化效应,将溶剂中的有机物从衬底表面剥离。
2. 过氧硫酸清洗
SPM溶液在改进RCA清洗工艺中也被称为“三号液”,能够彻底清除玻璃或硅片表面的几乎所有有机物,同时可使大部分材料的表面发生羟基化。SPM由H2SO4和H2O2组成,二者按照5:1至2:1的比例混合。H2SO4的作用是使有机污染物脱水碳化,H2O2的作用是将碳化产物氧化产生气体,因此SPM具有较强的氧化能力,不仅可以将硅片表面的金属氧化,也能将有机物氧化生成CO2和水。常用的清洗方法是将硅片放入120-150℃的SPM溶液中浸泡10-20min,紧接着用去离子水彻底清洗。
传统SPM溶液虽能有效分解大部分有机物,但硅片表面会残留一些硫化物,这些硫化物与硅基底结合能高,难以通过常规去离子水冲洗去除。改进型SPM清洗溶液为H2SO4:H2O2:HF=5:1:0.1,该溶液可以使硫化物转化为氟化物而被冲洗掉。
3. RCA清洗
该工艺是将晶圆片按顺序放入两种化学溶液中:1号标准清洗液(SC-1/APM)和2号标准清洗液(SC-2/HPM)。1号液是由氢氧化铵、过氧化氢和去离子水按1:1:5至1:2:7的体积比混合而成的碱性溶液。将硅片放入65-80℃的SC-1溶液中浸泡10-20min,主要作用是去除表面的颗粒和有机物质。主要原理:基于H2O2的强氧化作用,氧化硅片表面以及附着的颗粒,使颗粒表面形成可分解的氧化层,削弱颗粒与硅片间的结合力,促使颗粒脱离表面进入溶液。此外,H2O2在硅片表面形成的氧化层也能够降低表面活性,抑制颗粒的二次吸附(图5)。

图5:氧化机理
NH4OH是碱性溶液,其OH-离子通过微刻蚀作用从颗粒底部切入硅表面,破坏颗粒附着结构,促使颗粒脱离基底;同时,硅片表面与颗粒在碱性环境中均形成负电荷层,借助同种电荷间的静电斥力,驱动颗粒进入溶液并有效抑制其再吸附(图6)。

图6:静电排斥作用
2号清洗液是由盐酸、过氧化氢和去离子水按1:1:6至1:2:8的体积比混合而成的酸性溶液。将硅片放入65-85℃的溶液中浸泡10min。主要作用是去除金属离子。作用机理是让硅片表面的金属形成可溶盐而被去除。主要原理:过氧化氢作为强氧化剂,能够氧化硅片表面的金属。盐酸与金属离子能够生成可溶性氯化物并溶于SC-2溶液中。
4. 干法清洗
干法清洗通过气相化学法去除晶圆表面的污染物。其核心工艺是将热化学气体或等离子态反应气体导入反应室,使气体与表面污染物发生化学反应生成易挥发产物并由真空系统抽离。其中热氧化法以含氯环境退火为典型代表。等离子清洗通过激光、微波或热电离将惰性气体激发为等离子态,产生活性粒子与污染物分子反应生成挥发性产物脱离表面,实现无损伤清洗。等离子体清洗过程如图7所示。

图7:等离子体清洗过程
与等离子体清洗类型的方法还有离子束清洗。离子束清洗采用几百电子伏的Ar或其他离子束轰击材料样品表面(如图8所示),在较高真空度环境中去除衬底表面的沾污,以达到清洗的目的。比如,用Ar离子束轰击Si衬底表面可去除其表面的碳氢化合物和其他污染物,增强Si衬底与其他膜层的黏附力。离子束清洗适用于金属、氧化物、半导体、其他化合物等表面,可实现高效的整体或局部清洗。

图8:离子束轰击
综上所述,衬底清洗本质是表面化学调控与污染物的去除过程,通过有机-碱-酸多级协同作用,实现有机残留、颗粒杂质与金属离子的高效去除,规范化清洗不仅决定表面微观形貌,更是影响薄膜生长、界面结合、器件电学性能及工艺良率的关键环节,是现代半导体制造中必须严格控制的基础工艺。
主要参考文章:
1.《简明光刻手册》王云翔著 哈尔滨工业大学出版社
2.《半导体晶圆的污染杂质及清洗技术》张士伟 中国电子科技集团公司第十三研究所